Upcoming Workshops (Singapore)
Workshops for learning
For more details of the workshops, pls sent email to admin@launchxtec.com
Venue: Newcastle Australia Institute of Higher Education Singapore, 230 Victoria Street, #04-09/10, Bugis Junction Towers, S188024
Registration fee: SGD 800 per workshop (3 weeks before the workshop) and SGD 1,000 per workshop thereafter. We are pleased to offer the following discounts for block booking:
10% discount for registering for 3–5 workshops (any combination)
15% discount for registering for >5 workshops (any combination)
Please request a quotation by emailing admin@launchxtec.com or proceed with registration and payment via PayNow.
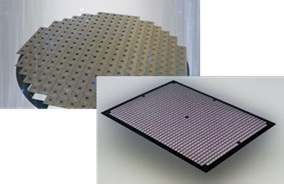
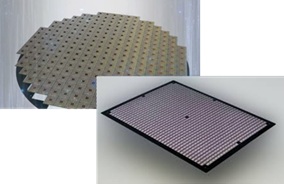
Breaking Down Fan-out Panel & Wafer-Level Packaging: Design, Assembly, and Competitive Technologies
(16-17 Apr 2026)
This workshop provides a comprehensive overview of chiplet-based and heterogeneous integration technologies, starting with IC packaging fundamentals, key market and technology drivers, and the industry shift from monolithic SoC toward modular SiP and chiplet architectures to enable scalability, performance, and design flexibility. It introduces Wafer Level Packaging with a focus on the limitations of Fan-In WLP and the advantages, evolution, and industry adoption of Fan-Out WLP as a critical enabler for high-density integration. Participants then explore wafer-level and panel-level FO-WLP through die-first and die-last architectures, real-world case studies from leading vendors, key assembly and reliability challenges, and future scaling toward PoP and panel-level manufacturing. The workshop concludes with an examination of emerging and competing technologies for advanced chiplet systems, including next-generation substrates, multi-dimensional packaging concepts, hybrid bonding, and glass core substrates, offering a forward-looking perspective on the future of advanced semiconductor packaging.


From PCB, Surface Mount Technology to joint reliability: PCB, SMT, soldering and its joint reliability
(25-26 May)
This comprehensive PCB & Assembly Excellence workshop offers an end-to-end technical deep dive designed to bridge the gap between initial design and high-reliability electronics manufacturing. Tailored for engineers and technicians, the program tracks the full lifecycle of a Printed Circuit Board, beginning with foundational material science (FR-4, polyimide, and CTE management) and progressing through precision fabrication flows like photolithography and advanced surface finishes. Participants will master high-density interconnect (HDI) strategies—including sequential build-up (SBU) and microvia stacking—while comparing the productivity of laser, plasma, and photo-via formation.
The curriculum further explores the critical physics of SMT assembly, from stencil aperture optimization to reflow profiling, before diving into the complex metallurgy of solder materials. By analyzing phase diagrams, IMC growth, and the performance of SnAgCu and Low-Temperature alloys, attendees will learn to predict and prevent failures. The workshop concludes with a rigorous focus on mechanical characterization and reliability, teaching you how to utilize ball shear testing and Weibull Distribution analysis to ensure your products withstand the thermal and mechanical stresses of real-world applications.
For workshop details, pls refer to the link
https://drive.google.com/file/d/13VQOFYusICXyIQXXopm8T7xwUIcTYdIB/view?pli=1
For workshop details, pls refer to the link
https://drive.google.com/file/d/1dUS8tQsCkJ5Gxew3I4eqrMUI67jjvzY7/view?pli=1
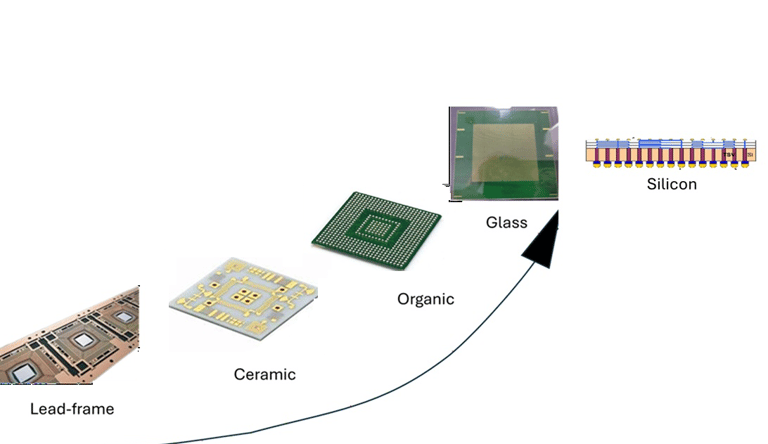
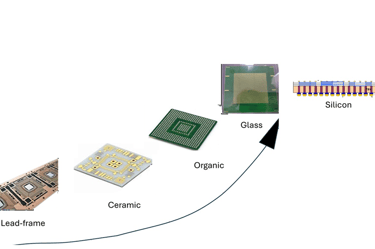
For workshop details, pls refer to the link
https://drive.google.com/open?id=1N1oEjn0eCTBicOrui4uLkVglt4cGXf5o&usp=drive_fs
Semiconductor Packaging Substrate and Interposers: From Leadframe, Ceramics, Organics to Silicon and Glass Substrates and Interposers
(25-26 Jun)
Unlock your competitive edge in the high-performance computing (HPC) and AI era with this comprehensive technical workshop. This intensive session charts the full evolution of semiconductor packaging, tracking the critical shift from high-power leadframe and rigid organic substrates to advanced silicon and glass-core interposers.
Designed specifically for packaging engineers and designers, the curriculum bridges fundamental material science with cutting-edge fabrication. Attendees will explore the processing flows of ceramics in DCB and AMB for power packaging, contrast BT and ABF organic substrates, and evaluate their rugged performance against the high-bandwidth potential of Through-Silicon Vias (TSV) and Through-Glass Vias (TGV).
Beyond foundational fabrication, the workshop delivers actionable strategies for navigating complex manufacturing realities. Key structural transitions will be analyzed in detail, showing how to move from traditional semi-additive patterning (SAP) to advanced sub-micron interconnects on silicon and glass interposers.
The final segment equips you with the design expertise required for next-generation architectures, focusing on TSMC’s CoWoS-S, CoWoS-R/L, and SoIC platforms. By analyzing the unique design constraints, routing rules, and thermal profiles of these high-density architectures, you will gain the specialized engineering insights needed to guide your organization through the industry’s transition toward next-generation interposer solutions.


Insight into Advanced Packaging and Trends for Business Executive
(23-24 Jul)
This Advanced Packaging Workshop is specifically designed for business executives to decode the strategic shift from traditional silicon design to the new frontier of Heterogeneous Integration. As Moore’s Law slows, the competitive edge has moved to the package, where Chiplets and 3D stacking now drive the performance gains once found only in the chip itself. This session strips away the technical jargon to focus on how architectures like CoWoS and Fan-Out are directly enabling the next generation of AI, 5G, and Automotive products while bypassing the soaring costs of monolithic chip manufacturing.
Through a commercial lens, the workshop provides critical supply chain intelligence and market-readiness insights. You will compare traditional assembly flows against modern System-in-Package (SiP) strategies to identify where value is captured and where risks reside in your roadmap. By understanding the transition to next-gen substrates and hybrid bonding, leaders will leave with the clarity needed to make high-stakes investment, sourcing, and partnership decisions in a landscape where packaging is now the primary driver of profitability and speed-to-market.
For workshop details, pls refer to the link
